Durante el proceso de fabricación de chips semiconductores, es necesario emplear técnicas de corte para cortar obleas. Sin embargo, el corte tradicional con diamante y con muela abrasiva puede causar daños importantes a los materiales semiconductores, provocando problemas como la fragmentación de las obleas y la degradación del rendimiento del chip.
En consecuencia, el desarrollo de tecnologías de corte avanzadas tiene una inmensa importancia para reducir costos y aumentar la eficiencia en la industria de semiconductores de circuitos integrados. Con el progreso de la tecnología láser, el corte por ablación por láser de alta potencia (es decir, corte por láser) y el corte sigiloso logrado utilizando láseres enfocados de baja potencia se están convirtiendo gradualmente en tecnologías de corte de virutas convencionales.
El corte por láser es un método de procesamiento sin contacto que, a diferencia del corte tradicional con diamante y muela abrasiva, evita la rotura de virutas, el desgaste de las herramientas, la contaminación del agua, los efectos térmicos y el atrapamiento de virutas, que son problemas importantes.
Sin embargo, los láseres de alta potencia utilizados en el corte por ablación por láser generan efectos térmicos sustanciales durante la operación, que pueden dañar fácilmente la película azul en la parte inferior durante el corte de la oblea, afectando así la técnica de procesamiento del chip. Por lo tanto, la tecnología de corte sigiloso se ha convertido gradualmente en un punto focal en la industria de fabricación de semiconductores.
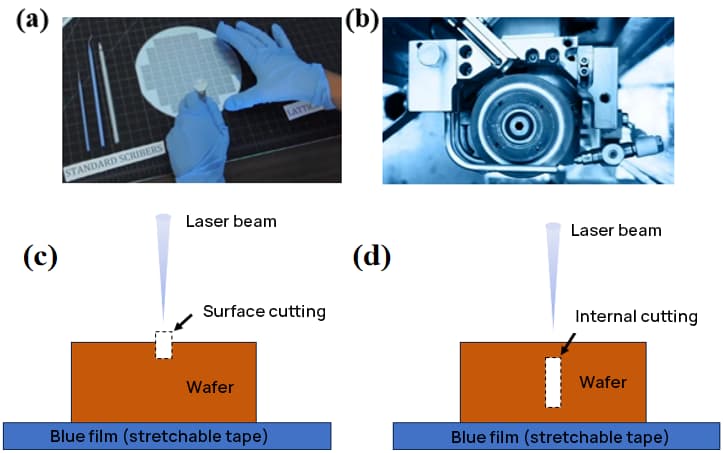
(a) Corte con disco de diamante (b) Corte con muela abrasiva (c) Tecnología Stealth Dicing (SD)
Advanced Dicing: explicación detallada de la tecnología Stealth Dicing y aplicaciones ilustrativas
La tecnología Stealth Dicing, al enfocar un láser para formar una pequeña área de punto de luz, puede generar una enorme densidad de energía, logrando así el corte de obleas.
Como proceso seco, Stealth Dicing ofrece ventajas como alta velocidad, alta calidad (ninguna o muy pocas virutas) y baja pérdida de corte. El proceso específico de Stealth Dicing se puede dividir en dos pasos:
(1) Perforación inducida por láser: como se muestra en la Figura 2, el sistema óptico enfoca un rayo láser pulsado que puede atravesar la oblea debajo de la superficie de la oblea. Cuando la densidad de potencia del láser en este punto de enfoque alcanza su punto máximo, se forma una perforación y en este punto los chips de oblea aún no están separados.
(2) Separación de virutas: después de desplegar la película azul colocada sobre la oblea, debido a las grandes tensiones de tracción y compresión presentes cerca de la perforación del láser, se pueden inducir grietas a lo largo de la trayectoria del láser dentro de la oblea, logrando la separación de virutas.

La tecnología de corte por láser furtivo ahora se ha aplicado a una variedad de escenarios de corte de obleas, tales como:
(1) Corte de obleas de silicio: cuando se utilizan discos de diamante convencionales para cortar silicio, el grosor, la granularidad, la rotación y la velocidad de corte de la hoja afectan significativamente la calidad del corte. A pesar de años de mejoras técnicas, el gran ancho de corte (corte) causado por la cuchilla todavía genera desperdicio de material.
Además, la generación de desechos y el desgaste de las cuchillas aumentan los costos de corte. Sin embargo, el uso de tecnología de corte láser sigilosa con una trayectoria de corte ultraestrecha puede eliminar los problemas de costos asociados con la limpieza adicional de desechos y desperdicios de material, mejorando así la productividad de las virutas. Además, al prevenir el daño térmico, la tecnología de corte láser sigiloso puede aumentar aún más el rendimiento de fabricación de chips.
(2) Corte con carburo de silicio: el carburo de silicio es un material ultraduro, solo superado por el diamante en dureza, lo que lo hace extremadamente difícil de mecanizar. En la preparación de materiales de sustrato de cristal de carburo de silicio de gran tamaño (6 pulgadas y más), la tecnología de corte por láser sigiloso, en comparación con la tecnología de corte con alambre abrasivo fijo (alambre de acero galvanizado con diamante), puede mejorar la eficiencia de corte de 3 a 5 veces.
Dado el importante problema del consumo de material, la tecnología de corte por láser sigiloso también puede aumentar la tasa de producción de obleas de carburo de silicio en más de un 30%.
(3) Corte de obleas especiales: Al utilizar tecnología de corte láser sigiloso para cortar obleas especiales (por ejemplo, obleas con películas delgadas montadas sobre chips o hechas de materiales de bajo k), es posible evitar la generación de fracturas y grietas, logrando Corte de obleas de alta eficiencia y alta precisión.
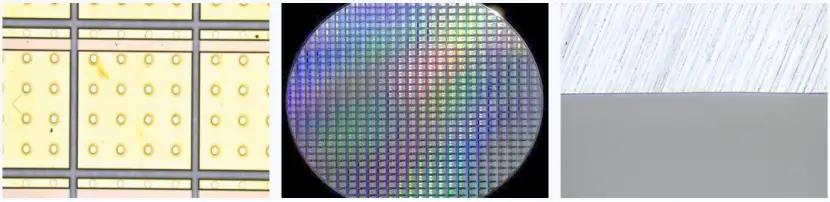
Avances en la tecnología de corte por láser sigiloso
A pesar de las numerosas ventajas de la tecnología de corte por láser furtivo, todavía existen varios problemas que interfieren con el proceso de corte. Como se muestra en la Figura 4, la deformación de la superficie de la oblea y los problemas de gestión de la densidad de potencia del láser pueden impedir que el enfoque del láser aterrice con precisión en capas delgadas específicas dentro de la oblea, lo que dificulta las mejoras en la precisión y la velocidad de corte.
Debido a la dificultad para aplicar uniformemente el rayo láser durante las etapas de aceleración, desaceleración y giro, pueden ocurrir fácilmente problemas de sobreprocesamiento. Además, problemas como interferencia analógica, no linealidad analógica, deriva analógica o retrasos en el bucle de corriente del controlador afectarán la precisión del control y la capacidad de respuesta de la plataforma de corte por láser.
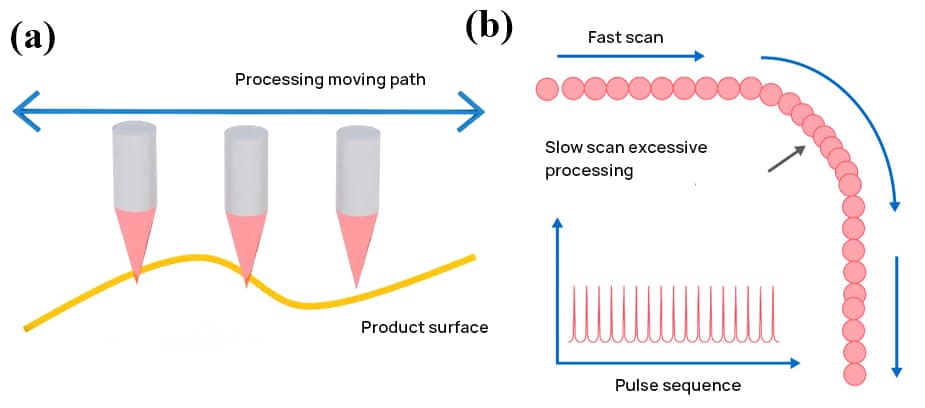
En respuesta a estos problemas, los sectores académico e industrial han propuesto una serie de soluciones, como se muestra en la Figura 5, que incluyen específicamente:
(1) Control de seguimiento de altura en tiempo real: durante el proceso de corte de la oblea, se utilizan sensores de desplazamiento para medir fluctuaciones diminutas de altura en la superficie del producto en tiempo real, y estas se compensan en tiempo real para el eje Z donde se encuentra el láser. asegurando que el enfoque del láser golpee con precisión una capa delgada específica de la oblea.
(2) Control de salida de comparación de posición de alta velocidad: el desarrollo de un algoritmo de seguimiento de altura evita eficazmente problemas excesivos de mecanizado durante la aceleración, desaceleración y giro del láser, asegurando que el láser actúe uniformemente sobre la pieza de trabajo.
(3) Tecnología de control PWM (modulación de ancho de pulso): al emitir directamente señales de conmutación digitales desde el controlador, que luego se amplifican a través de un módulo de amplificación de potencia para controlar directamente el circuito de corriente del motor, una mejora en la precisión del control de la plataforma de corte por láser más rápido y directo. y se logra la capacidad de respuesta.

Con respecto al área de acción pequeña y el problema del ajuste de potencia del corte sigiloso con láser de enfoque único, se ha desarrollado específicamente la tecnología de corte sigiloso con láser de enfoque múltiple. Esta técnica puede enfocar y generar simultáneamente múltiples puntos focales dentro de la oblea para cortar, lo que aumenta significativamente la eficiencia del corte, como se muestra en la Figura 6.
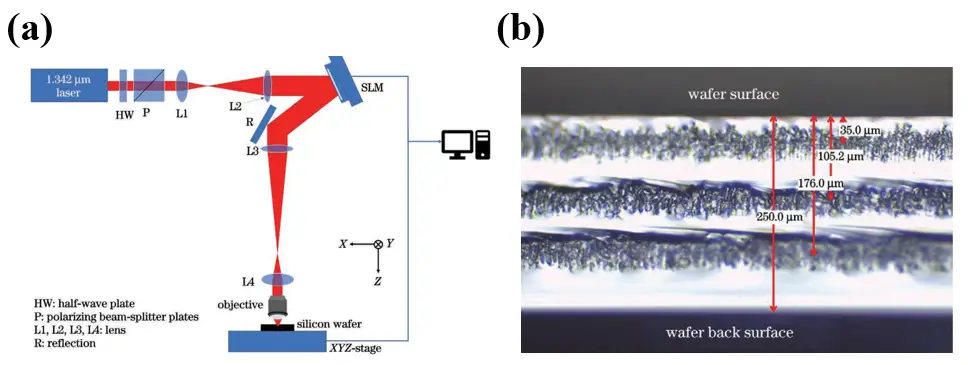
Durante el proceso de corte sigiloso con láser multifocal, la posición y la intensidad del rayo láser influyen en gran medida en la calidad del corte. Debido a la diferencia significativa en los índices de refracción entre el aire y los materiales semiconductores, el rayo láser que actúa dentro de la oblea puede causar un fenómeno de dispersión del punto focal, lo que requiere corrección de la aberración.
Para satisfacer las necesidades de corte de obleas en diversos escenarios de aplicación, se han abordado estos problemas mediante avances técnicos, como la regulación de la posición y la intensidad de múltiples focos y el desarrollo de tecnologías de corrección de aberraciones para superar la dispersión focal.
Tecnología de corte por láser sigilosa: un mundo con mayor potencial
En comparación con las tecnologías de corte tradicionales, el corte sigiloso por láser tiene ventajas notables en aplicaciones prácticas, incluida una eficiencia significativamente mayor, una calidad superior y menores pérdidas.
Al optimizar y explorar aún más la tecnología de corte sigiloso con láser, por ejemplo, ajustando la energía del haz durante el proceso de corte sigiloso para obtener rugosidad de la superficie del chip fotónico o aumentando la eficiencia del corte sigiloso con láser, creemos firmemente que esta tecnología brillará en el futuro. campo de la fabricación de semiconductores de circuitos integrados, así como otros dominios emergentes.

























































