Durante o processo de fabricação de chips semicondutores, é necessário empregar técnicas de fatiamento para cortar wafers. No entanto, o corte tradicional de diamante e o corte do rebolo podem causar danos significativos aos materiais semicondutores, levando a problemas como fragmentação do wafer e degradação do desempenho do chip.
Conseqüentemente, o desenvolvimento de tecnologias avançadas de corte tem imensa importância para a redução de custos e aumento de eficiência na indústria de semicondutores de circuitos integrados. Com o progresso da tecnologia laser, o corte por ablação a laser de alta potência (ou seja, corte a laser) e o corte furtivo obtido usando lasers focados de baixa potência estão gradualmente se tornando tecnologias convencionais de corte de chips.
O corte a laser é um método de processamento sem contato que, diferentemente do corte tradicional com diamante e do rebolo, evita a quebra de cavacos, o desgaste da ferramenta, a poluição da água, os efeitos térmicos e o aprisionamento de cavacos, que são problemas significativos.
No entanto, os lasers de alta potência usados no corte por ablação a laser geram efeitos térmicos substanciais durante a operação, que podem facilmente danificar o filme azul na parte inferior durante o corte do wafer, impactando assim a técnica de processamento do chip. Portanto, a tecnologia de corte furtivo tornou-se gradualmente um ponto focal na indústria de fabricação de semicondutores.
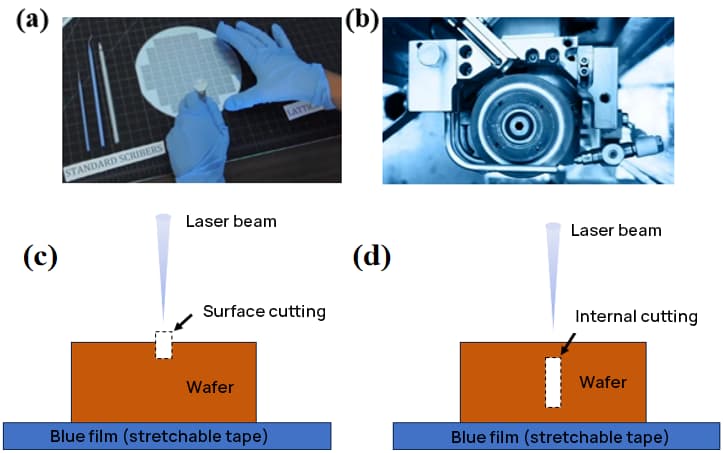
(a) Corte com lâmina de diamante (b) Corte com rebolo (c) Tecnologia Stealth Dicing (SD)
Corte avançado: explicação detalhada da tecnologia Stealth Dicing e aplicações ilustrativas
A tecnologia Stealth Dicing, ao focar um laser para formar uma pequena área de ponto de luz, pode gerar enorme densidade de energia, conseguindo assim o corte do wafer.
Como um processo a seco, o Stealth Dicing oferece vantagens como alta velocidade, alta qualidade (nenhum ou muito poucos chips) e baixa perda de corte. O processo específico de Stealth Dicing pode ser dividido em duas etapas:
(1) Perfuração induzida por laser: Conforme mostrado na Figura 2, um feixe de laser pulsado que pode passar pelo wafer é focado abaixo da superfície do wafer pelo sistema óptico. Quando a densidade de potência do laser neste ponto de foco atinge seu pico, uma perfuração é formada e, neste ponto, os chips do wafer ainda não estão separados.
(2) Separação de cavacos: Após desdobrar o filme azul colocado no wafer, devido às grandes tensões de tração e compressão presentes perto da perfuração do laser, rachaduras podem ser induzidas ao longo do caminho do laser dentro do wafer, conseguindo a separação dos cavacos.

A tecnologia de corte a laser Stealth agora foi aplicada em uma variedade de cenários de corte de wafer, como:
(1) Corte de wafer de silício: Ao usar lâminas de diamante convencionais para cortar silício, a espessura, granularidade, rotação e velocidade de corte da lâmina afetam significativamente a qualidade do corte. Apesar de anos de melhorias técnicas, a grande largura de corte (corte) causada pela lâmina ainda leva ao desperdício de material.
Além disso, a geração de detritos e o desgaste da lâmina aumentam os custos de corte. No entanto, o uso da tecnologia de corte a laser furtivo com um caminho de corte ultraestreito pode eliminar os problemas de custo associados à limpeza adicional de detritos e desperdício de material, melhorando assim a produtividade dos cavacos. Além disso, ao evitar danos térmicos, a tecnologia de corte a laser furtivo pode aumentar ainda mais o rendimento da fabricação de chips.
(2) Corte de carboneto de silício: O carboneto de silício é um material ultraduro, perdendo apenas para o diamante em dureza, tornando-o extremamente difícil de usinar. Na preparação de materiais de substrato de cristal de carboneto de silício de tamanho grande (6 polegadas e acima), a tecnologia de corte a laser furtivo, em comparação com a tecnologia de corte de fio abrasivo fixo (galvanizado com diamante em fio de aço), pode melhorar a eficiência de corte em 3 a 5 vezes.
Dada a questão significativa do consumo de material, a tecnologia de corte a laser furtivo também pode aumentar a taxa de produção de wafers de carboneto de silício em mais de 30%.
(3) Corte especial de wafer: Ao usar tecnologia de corte a laser furtivo para cortar wafers especiais (por exemplo, wafers com filmes finos montados em chips ou feitos de materiais de baixo k), é possível evitar a geração de fraturas e rachaduras, conseguindo corte de wafer de alta eficiência e alta precisão.
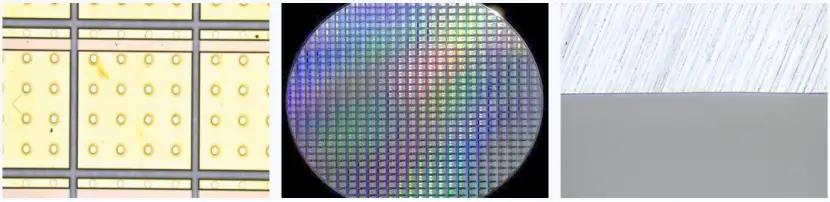
Avanços na tecnologia de corte furtivo a laser
Apesar das muitas vantagens da tecnologia de corte furtivo a laser, uma série de problemas ainda interfere no processo de corte. Conforme mostrado na Figura 4, o empenamento da superfície do wafer e os problemas no gerenciamento da densidade de energia do laser podem impedir que o foco do laser pouse com precisão em camadas finas específicas dentro do wafer, dificultando melhorias na precisão do corte e na taxa de rendimento dos cavacos.
Devido à dificuldade em aplicar uniformemente o feixe de laser durante os estágios de aceleração, desaceleração e curvas, podem ocorrer facilmente problemas de processamento excessivo. Além disso, problemas como interferência analógica, não linearidade analógica, desvio analógico ou atrasos no circuito de corrente do driver afetarão a precisão do controle e a capacidade de resposta da plataforma de corte a laser.
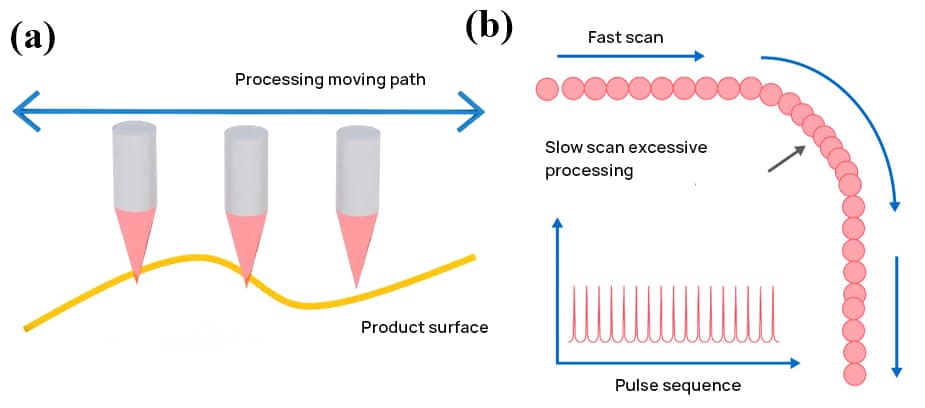
Em resposta a estas questões, os setores académico e industrial propuseram uma série de soluções, conforme mostrado na Figura 5, que incluem especificamente:
(1) Controle de acompanhamento de altura em tempo real: Durante o processo de corte do wafer, sensores de deslocamento são usados para medir flutuações mínimas de altura na superfície do produto em tempo real, e estas são compensadas em tempo real para o eixo Z onde o laser está localizado , garantindo que o foco do laser atinja com precisão uma camada fina específica do wafer.
(2) Controle de saída de comparação de posição de alta velocidade: O desenvolvimento de um algoritmo de acompanhamento de altura evita efetivamente problemas de usinagem excessiva durante a aceleração, desaceleração e curvas do laser, garantindo que o laser atue uniformemente na peça de trabalho.
(3) Tecnologia de controle PWM (modulação por largura de pulso): Ao emitir diretamente sinais de comutação digital do controlador, que são então amplificados por meio de um módulo de amplificação de potência para controlar diretamente o circuito de corrente do motor, um aprimoramento mais rápido e direto da plataforma de corte a laser precisão de controle e capacidade de resposta são alcançadas.

Em relação à pequena área de ação e ao problema de ajuste de potência do corte furtivo a laser de foco único, a tecnologia de corte furtivo a laser multifoco foi desenvolvida especificamente. Esta técnica pode focar e gerar simultaneamente vários pontos focais dentro do wafer para corte, aumentando significativamente a eficiência do corte, conforme mostrado na Figura 6.
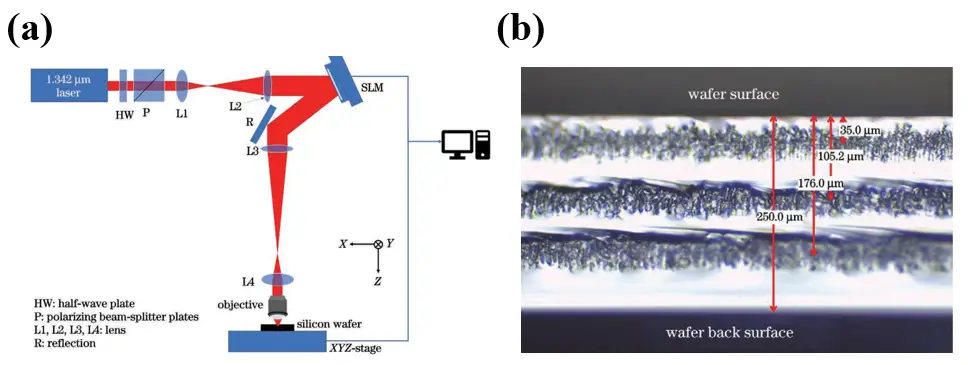
Durante o processo de corte furtivo a laser multifocal, a posição e a intensidade do feixe de laser influenciam muito a qualidade do corte. Devido à diferença significativa nos índices de refração entre o ar e os materiais semicondutores, o feixe de laser que atua dentro do wafer pode causar um fenômeno de dispersão do ponto focal, necessitando assim de correção de aberração.
Para atender às necessidades de corte de wafer em vários cenários de aplicação, as pessoas têm abordado essas questões através de avanços técnicos, como a regulação da posição e intensidade de múltiplos focos e o desenvolvimento de tecnologias de correção de aberração para superar a dispersão do ponto focal.
Tecnologia de corte furtivo a laser: um mundo de maior potencial
Em comparação com as tecnologias de corte tradicionais, o corte furtivo a laser apresenta vantagens notáveis em aplicações práticas, incluindo eficiência significativamente maior, qualidade superior e menor perda.
Ao otimizar e explorar ainda mais a tecnologia de corte furtivo a laser, por exemplo, ajustando a energia do feixe durante o processo de corte furtivo para obter rugosidade superficial do chip fotônico ou aumentando a eficiência do corte furtivo a laser, acreditamos firmemente que esta tecnologia brilhará intensamente no campo da fabricação de semicondutores de circuitos integrados, bem como em outros domínios emergentes.

























































